通过晶圆级封装的Bumping (凸块) 和 RDL (重布线)技术,在晶圆的表面实I/O的重新Layout 及Solder / Copper pillar bump 的引出实现倒装芯片的凸块加工,进一步实现先进细间距(Fine-pitch) Flipchip封装;以及通过向芯片内或外的扇入/扇出(Fan-in/Fan-out) 技术实现WLP(Wafer level PKG,晶圆级封装)技术,并藉由双面Fan-out 及 TSV 硅穿孔技术实现2D/2.5D/3D 的先进晶圆级封装技术。
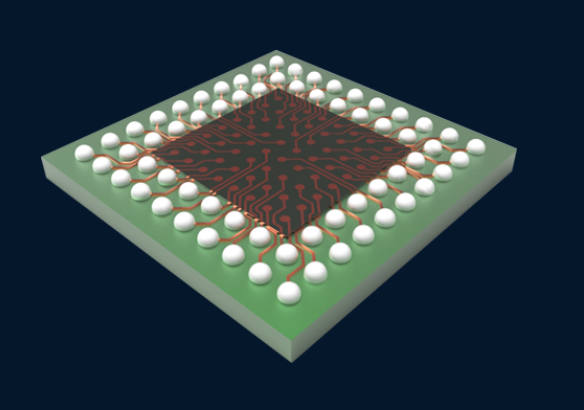
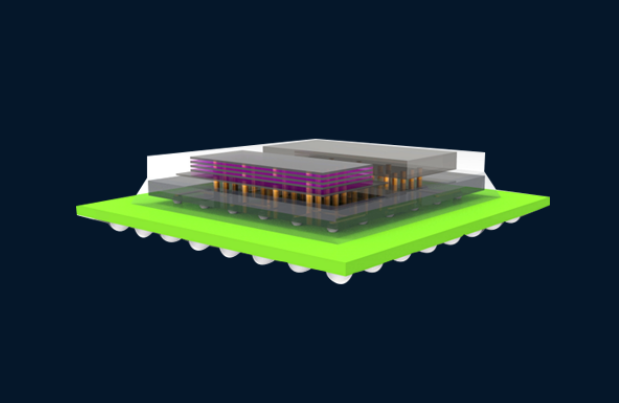

 已点赞
已点赞
 点赞
点赞
 已收藏
已收藏
 收藏
收藏
通过晶圆级封装的Bumping (凸块) 和 RDL (重布线)技术,在晶圆的表面实I/O的重新Layout 及Solder / Copper pillar bump 的引出实现倒装芯片的凸块加工,进一步实现先进细间距(Fine-pitch) Flipchip封装;以及通过向芯片内或外的扇入/扇出(Fan-in/Fan-out) 技术实现WLP(Wafer level PKG,晶圆级封装)技术,并藉由双面Fan-out 及 TSV 硅穿孔技术实现2D/2.5D/3D 的先进晶圆级封装技术。